Технологии памяти для мобильных устройств
Андрей Борзенко
Рынок портативных устройств развивается довольно быстрыми темпами. По мнению большинства аналитиков, существенный его рост ожидается в начале этого тысячелетия. Наряду с карманными компьютерами и игровыми машинками, смарт-картами и цифровыми камерами начинают широко использоваться портативные коммуникационные терминалы и разнообразные мультимедийные устройства.
Неотъемлемый элемент всех этих электронных приборов — память для хранения программ и данных. Но разные типы или виды памяти в большинстве случаев, к сожалению, не взаимозаменяемы. Все они отличаются по скорости, потребляемой мощности, стоимости и ряду других, часто не менее важных параметров. Каждый тип памяти по одной или нескольким характеристикам предпочтителен для одних приложений, но совсем не годится для других. В результате производители электронного оборудования просто вынуждены использовать широкую номенклатуру запоминающих устройств.
Требования, предъявляемые к памяти для портативных устройств, общеизвестны, — это низкое энергопотребление, высокая скорость работы, большая емкость и энергонезависимость (т. е. способность сохранять информацию в случае отключения источника питания). Поскольку до недавнего времени обеспечить должный уровень всех этих параметров не представлялось возможным, то приходилось искать компромиссное решение.
Например, для получения высокой скорости обработки данных можно использовать статическую память SRAM (Static RAM) с низким энергопотреблением, что, однако, ограничивает ее быстродействие. Для обеспечения энергонезависимости в этом случае дополнительно нужен либо источник питания (гальванический элемент или аккумулятор), либо электрически программируемое постоянное запоминающее устройство EEPROM (Electrically Erasable Programmable ROM).
Если требования к скорости работы не слишком жесткие, наиболее эффективным решением считается использование флэш-памяти, одной из разновидностей энергонезависимой памяти. В основе работы запоминающей ячейки этого типа лежит физический эффект Фаули — Нордхайма (Fowler — Nordheim), связанный с лавинной инжекцией зарядов в полевых транзисторах. Как и у EEPROM, содержимое флэш-памяти программируется электрическим способом, однако основное ее преимущество по сравнению с той же EEPROM — высокая скорость доступа и довольно быстрое стирание информации. Благодаря невысокой цене и приемлемым параметрам флэш-память широко используется в персональных компьютерах, сотовых телефонах, сетевом оборудовании, принтерах, факс-машинах и т. д.
Несмотря на неисчерпанные возможности совершенствования флэш-памяти, многие эксперты склонны считать, что на рынке портативных устройств вскоре появятся два новых типа памяти — ферроэлектрический (FRAM, Ferroelectric RAM) и магнитный MRAM (Magnetic RAM). К новым микросхемам для мобильных устройств предъявляются вполне определенные требования. Первое: ячейка такой памяти должна иметь микронные размеры, обеспечивать совместимость с существующими производственными линиями и быть не дороже элементов динамической памяти DRAM (Dynamic RAM). Второе: кристалл должен потреблять как можно меньше энергии, чтобы его можно было использовать в мобильных устройствах. И, наконец, третье: скорость, скорость и скорость.
Ферроэлектрическая память
Первые элементы FRAM были созданы корпорацией Ramtron (http://www.ramtron.com)
еще в 1984 г. Лицензию у нее приобрели крупнейшие производители памяти — Hitachi,
Toshiba, Fujitsu, Rohm и Samsung Electronics. Подход к созданию данного типа
памяти в корне отличается от традиционного, где используются обычные кремниевые
технологии. Дело в том, что в элементах FRAM применяется сегнетоэлектрическая
пленка на основе сплавов оксидов металлов (титана, циркония, свинца и т. п.)
— отсюда и название "ферро". Типичные примеры сегнетоэлектрических пленок —
PZT, BST, Y1 и SBT.
Стоит напомнить, что сегнетоэлектрики благодаря доменной структуре в определенном диапазоне температур обладают способностью к самопроизвольной поляризации, сильно зависящей от внешних воздействий. Принцип работы запоминающей ячейки FRAM (рис. 1) основан на том, что внешнее электрическое поле перемещает атом сегнетоэлектрика в кристалле в одно из двух стабильных положений. Главная особенность FRAM — сохранение информации при выключении питания. Однако это не перепрограммируемое ПЗУ, так как у данного типа памяти отсутствует явно выраженный цикл стирания информации. Поляризация сегнетоэлектрика характеризуется петлей гистерезиса, следовательно, существуют два порога напряжения, при достижении которых можно изменить направление поляризации на противоположное. Обычно проводят аналогию с электрическим конденсатором, имеющим два устойчивых состояния (заряжен и разряжен, 0 и 1). В каком-то смысле ферроэлектрические элементы можно сравнить с ферритовыми сердечниками, поскольку ферромагнитные материалы также характеризуются гистерезисом, только магнитным. Как известно, ферритовые сердечники использовались в компьютерах 50-60-х гг.
 |
Рис. 1. Принцип работы памяти FRAM.
|
Как и DRAM, кристалл FRAM имеет несложную структуру и высокий коэффициент плотности размещения элементов. Ячейка памяти элементов FRAM включает обычно два транзистора и два конденсатора (2T/2C). Таким образом, основа FRAM — это конденсатор, представляющий собой две пластины с тонким слоем ферроэлектрика между ними (точнее, это вещество с похожими электрическими свойствами, но из которого можно изготовлять сверхтонкие пленки, используемые при производстве микроскопических ячеек памяти). Наложенный на обкладки конденсатора потенциал поляризует ферроэлектрик. Направление поляризации представляет собой двоичную информацию, хранящуюся в ячейке. При повторном наложении потенциала заряд, затрачиваемый на реполяризацию, будет зависеть от того, совпадает ли направление электрического поля с тем, которое поляризовало ферроэлектрик в прошлый раз. Если направление поля не совпадает, то на изменение поляризации требуется значительный заряд. Таким образом, если при повторном наложении потенциала наблюдается электрический ток, то направление не совпадает с предыдущим. На практике используют дифференциальный метод, позволяющий обойтись без абсолютных значений тока, чтобы предотвратить ошибки за счет расхождения параметров отдельных ячеек.
Поскольку каждая ячейка представляет собой два ферроэлектрических конденсатора, которые всегда поляризуются в противоположных направлениях, при считывании информации к обоим конденсаторам прикладывается одинаковый потенциал (например, соответствующий состоянию "1"). По разнице токов определяется, была записана в ячейку единица или ноль. Дифференциальный метод хорош тем, что любые изменения характеристик материала компенсируются использованием второго конденсатора из такого же материала. Однако одна ячейка занимает вдвое больше места, и при переходе к производству микросхем с высокой емкостью скорее всего будет применяться абсолютный метод с одним конденсатором. В этом случае ток следует сравнивать с током опорной ячейки с заранее известной поляризацией или же замерять его абсолютные значения.
Как и в случае с DRAM, чтение данных приводит к их разрушению, и информацию нужно восстанавливать после каждой операции считывания. FRAM по быстродействию пока еще не может сравниться с динамической, а тем более со статической памятью. Однако это сильный конкурент флэш-памяти и EEPROM, среднее время считывания информации у которых составляет около 10 мс. Отсутствие необходимости в высоком напряжении для записи информации, большой срок службы, низкое энергопотребление должны обеспечить надежный спрос на эти микросхемы в мобильных устройствах.
Стоит особо подчеркнуть, что FRAM имеет высокую степень энергонезависимости. Например, подобная микросхема может работать от одного уровня напряжения питания, не требуя дополнительного уровня для записи или стирания информации. Благодаря этому общее потребление энергии ниже, чем у других типов запоминающих устройств. Энергонезависимые устройства памяти, такие, как флэш-память и EEPROM, требуют больше энергии для работы и, что немаловажно, выходят из строя при значительно меньшем количестве перезаписей, чем допускает FRAM (по прогнозам, у FRAM эта цифра возрастет до 10 млрд.).
Некоторые элементы FRAM уже строятся на основе структуры 1T/1C. В частности, в прошлом году Ramtron и Fujitsu продемонстрировали 1-Мбитный кристалл FRAM, имеющий структуру 1T/1C. Некоторые эксперты считают такую структуру нестабильной в работе и в качестве промежуточного решения предлагают ввести в нее второй конденсатор — 1Т/2С.
Что касается производства FRAM, то уже сложились устойчивые альянсы, состоящие
обычно из научно-исследовательских центров, занимающихся технологией сегнетоэлектрических
пленок, и крупных корпораций, имеющих полупроводниковое производство. Так, корпорация
Ramtron (http://www.ramtron.com) активно
сотрудничает с японским концерном Asahi Chemical Industry. Компания Texas Instruments
(http://www.ti.com) совместно с ATMI (Advanced
Technology Material Inc.) создает ячейки FRAM со структурой 1Т/1С, работающие
от напряжения питания менее 2 В. Главный соперник Ramtron — компания Symetrix
(http://www.symetrixcorp.com), изготовитель
сегнетоэлектрических пленок Y1 и SBT, а также Matsushita Electronics, Motorola
(http://www.motorola.com) и Micron (http://www.micron.com)
основные усилия сосредоточили на создании FRAM для смарт-карт. Один из заводов
Matsushita уже выпускает кристаллы ферроэлектрической памяти с соблюдением проектных
норм 0,6 мкм из 6-дюймовых пластин. Идет подготовка к запуску линий, для которых
проектные нормы для 8-дюймовых пластин будут ужесточены сначала до 0,35 мкм.
Компании Infineon (http://www.infineon.com),
Toshiba (http://www.toshiba.co.jp) и
Samsung Electronics (http://samsungelectronics.com)
(по лицензии Ramtron) создали 4-Мбитный чип FRAM с соблюдением проектных норм
0,6 мкм. Отметим, что корпорация Samsung Electronics объявила о поставке первых
партий 64-Кбитных микросхем FRAM еще в 1998 г. Эти устройства имели усовершенствованную
структуру 1Т/1С. Для улучшения интеграции и быстродействия при ее создании использовался
специальный процесс двухслойной металлизации. Готовы к производству ферроэлектрической
памяти компании Siemens AG, Hyundai, Motorola, NEC и т. д.
Устройства FRAM (рис. 2) постепенно начинают заменять кристаллы SRAM и флэш-памяти в соответствующих товарах. Однако вскоре ферроэлектрической памяти придется конкурировать с другим поколением энергонезависимой магнитной памяти — MRAM.
 |
Рис. 2. Микросхемы памяти FRAM.
|
Магнитная память
MRAM объединяет быстродействие динамической памяти с преимуществами магнитных запоминающих устройств (сохранение информации без потребления энергии). Кроме того, она лишена одного из основных недостатков этого типа памяти — необходимости периодически обновлять хранимую информацию. По мнению экспертов из корпорации Semico Research, MRAM может стать достойным преемником обычной динамической памяти. Действительно, в компьютерах, где используется новый тип памяти, при отключении энергоснабжения данные не пропадут даже в отсутствие источника бесперебойного питания. Больше не потребуется перезагружать ОС при каждом включении устройства. В портативных ПК можно будет позабыть о технологиях типа Suspend To Disk, когда содержимое оперативной памяти сохраняется на жестком диске. Сотовые телефоны и коммуникаторы смогут хранить огромное количество информации, причем это никак не скажется на сроке автономной работы их аккумуляторов или гальванических элементов.
MRAM предполагается использовать в пейджерах, портативных и карманных ПК, автомобильной электронике и персональных цифровых секретарях (PDA), диагностическом и медицинском оборудовании — в общем, везде, где требуется быстрый доступ к информации, которая не должна теряться при отключении электропитания. Впрочем, не останутся в стороне и другие области. Например, MRAM может найти применение в видеомагнитофонах, микроволновых печах, калькуляторах, цифровых часах и т. п.
К основным достоинствам нового типа памяти относятся малое энергопотребление, низкая стоимость и высокая плотность элементов (ячеек хранения). Более того, разработчики утверждают, что технологический процесс для производства MRAM проще и дешевле, чем для DRAM, а, кроме того, не требует экзотических материалов.
Как известно, магнитная пленка, в отличие от заряда на крохотном p-n-переходе конденсатора, практически не подвержена "амнезии". Живой пример тому — жесткие магнитные диски. Но в них читает и записывает миллионы бит информации на магнитную пленку одна головка. Можно, конечно, представить, что для каждого хранимого бита информации существует свой датчик, но реализовать это гораздо сложнее.
Корпорации Honeywell (http://www.ssec.honeywell.com)
еще в 1997 г. удалось создать коммерческий образец магнитной памяти. Но он оказался
существенно дороже и в 10 раз медленнее, чем ячейка DRAM, а, кроме того, плотность
элементов в нем была в 256 раз меньше. Сначала команда, работавшая в Honeywell,
использовала так называемую анизотропную магниторезистивную (Anisotropic MagnetoResistance,
AMR) технологию, а позднее — "гигантский магниторезистивный" эффект GMR (Giant
MagnetoResistance), открытый более десяти лет назад. Он состоит в том, что в
магнитном поле электрическое сопротивление тонкой магнитной пленки меняется
на несколько процентов. Отметим, что данный эффект находит применение в современных
накопителях на жестких дисках. К сожалению, GMR-устройства потребляют довольно
большой ток, поэтому первоначально при уменьшении размеров транзисторов возникали
проблемы.
Группа исследователей из центра в Аризоне, принадлежащего корпорации Motorola
(http://www.motorola.com), смогла обойти
это ограничение с помощью так называемого псевдо-вращающегося вентиля (pseudo-spin
valve). Им удалось практически удвоить действие GMR-эффекта. Результатом работы
стала матрица памяти 8х8 разрядов, построенная на базе стандартных транзисторных
схем.
Ученые из корпорации IBM (http://www.ibm.com)
работали в другом направлении. Они начали создавать устройство, использующее
туннельный эффект через тонкий изолятор. Слабый туннельный ток менялся почти
на 30% в зависимости о того, в каком направлении действовали поля соседних магнитов
(в одном или противоположных). И здесь были достигнуты определенные результаты.
Исследователям удалось создать матрицу емкостью 14 бит, для хранения каждого
из которых требовалось всего 200 нм, а время переключения составляло не более
5 нс.
Стоит упомянуть, что пробные элементы магнитных запоминающих устройств были
созданы в исследовательском центре IMEC (Бельгия), а также корпорацией Toshiba
(http://www.toshiba.com). Здесь основа
запоминающей ячейки — многослойный магнитный вентиль, выполненный в полупроводниковой
структуре кристалла. Согласно имеющейся информации, длительность цикла записи-чтения
для этих устройств не превышает 6 нс.
Корпорация Micromem Technology (http://www.micromeminc.com)
также создала 8-разрядные образцы MRAM. В основе подхода, которым воспользовались
специалисты, лежал эффект, известный уже более 120 лет. Именно тогда американский
физик Эдвин Холл открыл явление, впоследствии названное его именем. Напомним,
что под эффектом Холла понимают возникновение в проводнике с током, помещенном
в магнитное поле, электрического поля с вектором напряженности, перпендикулярным
магнитному.
В отличие от полупроводниковой памяти подложкой для MRAM может служить не только кремний или арсенид галлия, но и обычное стекло, а в перспективе даже пластик. В ячейке MRAM не используется кремний. Каждый бит информации в MRAM хранится в полоске ферромагнитного материала, обладающего специальными свойствами. Она не похожа на обычный (в нашем понимании) магнит, который имеет два фиксированных полюса — северный и южный. Дело в том, что полюса MRAM меняются местами при посылке короткого импульса тока через проводник, который окружает этот магнит, после чего такая ориентация удерживается неограниченно долго. Особая ориентация магнитных полюсов определяется направлением электрического импульса по известному правилу "правой руки". Иными словами, импульсы, посланные в разных направлениях, меняют положение полюсов на противоположное. Это аналогично записи логического нуля или единицы. Миниатюрные датчики, установленные по краям магнита, фиксируют его полярность, не нарушая при чтении запомненное значение. Заметим, что эти датчики реагируют не на изменения электрического напряжения или сопротивления, благодаря чему чтение и запись происходят исключительно быстро.
Вообще говоря, запоминающий элемент MRAM (рис. 3) во многом похож на магниторезистивные головки, широко применяющиеся в современных жестких дисках. Он представляет собой "сэндвич", в котором слой магниторезистивного материала заключен между двумя слоями ферромагнетика. Проводимость магниторезистивного слоя, как известно, зависит от магнитного поля, в которое он помещен. Очевидно, что внутри запоминающего элемента MRAM это поле, а значит, и сопротивление находящегося в нем магниторезистивного материала, будет определяться ориентацией магнитных моментов ферромагнитных слоев. Считается, что когда их магнитные моменты ориентированы в одном направлении, то элемент имеет значение 0, а когда в противоположных — 1. Отсюда, кстати, видно, почему память MRAM энергонезависима — изменить ориентацию магнитного момента можно только внешним воздействием. Обращает на себя внимание и тот факт, что для управления элементом памяти достаточно управлять магнитным моментом только в одном из ферромагнитных слоев, а во втором слое он может оставаться постоянным.
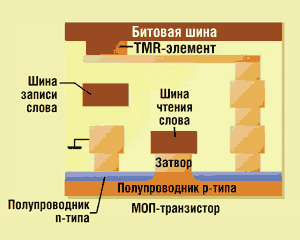 |
Рис. 3. Ячейка памяти MRAM.
|
В предлагаемых на сегодняшний день решениях на базе MRAM для записи данных используется массив взаимно перпендикулярных шин, в точках пересечения которых размещены запоминающие элементы (рис. 4, 5). При этом изменение состояния элемента возможно только при одновременном прохождении тока через обе пересекающие его шины. Наиболее распространенный метод выбора запоминающего элемента для считывания информации из памяти MRAM основан на применении полевых транзисторов. При подобном подходе размер ячейки памяти, которая будет состоять из описанного выше запоминающего элемента и транзистора, задается именно последним, поскольку он значительно больше. Таким образом, в принципе возможно достичь той же степени интеграции ячеек, что и в динамической памяти. Более того, в технологии DRAM, как отмечают специалисты, размер ячейки даже в большей мере зависит от размера конденсатора, а не транзистора. По этой причине степень интеграции MRAM может быть выше.
 |
Рис. 4. Архитектура MRAM.
|
| Рис. 5. Кристалл MRAM.
|
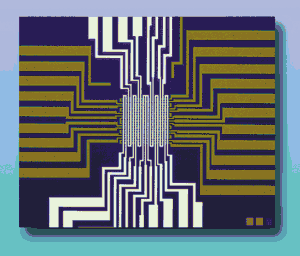 |
В последние несколько лет в корпорации IBM ведутся интенсивные исследования в области туннельной магниторезистивной технологии (Tunneling MagnetoResistance, TMR), элементы которой используют магнитный туннельный переход (Magnetic Tunnel Junction, MTJ). Надо заметить, что первое работающее MTJ-устройство было создано в Массачусетском технологическом институте физиками Джагадишем Мудерой (Jagadeesh Moodera) и Робертом Месерви (Robert Meservey). IBM в 1974 г. представила миниатюрное устройство, в котором был реализован этот физический эффект. В конце концов, адаптировав его для задач хранения информации, в 1998 г. корпорация создала реально работающие микросхемы памяти MRAM. Одно из главных отличий MTJ- от GMR-элементов состоит в том, что в них при считывании ток пропускается не параллельно, а перпендикулярно слоям структуры. Применение TMR-технологии позволило увеличить магниторезистивный эффект до 20%. Более того, уже получены структуры, в которых его величина достигает 40-50%. Плюс к этому сопротивление TMR-структур чуть ли не на порядок выше сопротивления GMR-структур. В 2000 г. корпорации IBM и Infineon Technologies подписали соглашение о совместной разработке технологии памяти MRAM. Функции выпуска нового класса устройств взяла на себя Infineon, опираясь на большой опыт в области производства электронных микросхем памяти высокой плотности.
В 2004 г. IBM планирует представить прототип модуля оперативной памяти, основанного на технологии MRAM; при этом емкость одного элемента составит 64 Кбайт. В прошлом году корпорация Motorola также продемонстрировала разработанный ею 256-Кбитный модуль магниторезистивной памяти MRAM, построенный по схеме 16Kx16. Напряжение питания у него составляет 3 В, уровень энергопотребления — 24 мВт, а длительность цикла чтения-записи не превышает 50 нс. По заявлению представителей Motorola, корпорация также надеется приступить к массовому производству памяти MRAM в 2004 г. По оценкам аналитиков компании Pathfinder Research, к 2005 г. спрос на микросхемы памяти MRAM может достичь 40 млрд долл.
Продолжение следует
Возможно, в недалеком будущем карманные компьютеры будут иметь память объемом
свыше 500 Мбайт (напомним, что у нынешних КПК обычно от 2 до 64 Мбайт флэш-памяти).
Разумеется, это станет возможным только при использовании каких-то новых технологий.
В частности, корпорация Intel (http://www.intel.com)
считает перспективными три технологии для запоминающих устройств: разновидность
ферроэлектрической памяти (Polymer Ferroelectric RAM), Ovonics Unified Memory
(в OUM используются те же материалы, что и в перезаписываемых компакт- и DVD-дисках)
и магнитное ОЗУ. Из упомянутых трех наиболее перспективна, скорее всего, технология
OUM, благодаря относительной дешевизне и простоте интеграции с другими технологиями
памяти. Модули запоминающих устройств MRAM и PFRAM обладают более высокой производительностью,
но они дороже в производстве, а, по мнению аналитиков, фирмы-производители портативных
устройств будут активно внедрять только ту технологию, которая окажется дешевле
нынешней флэш-памяти. Каких-либо конкретных сроков начала производства модулей
OUM-памяти нового поколения не называется, но, по мнению специалистов, это произойдет
где-то в конце 2003 г. По имеющейся информации, в настоящее время Intel ведет
разработки сразу в трех направлениях — MRAM, PFRAM и OUM, но какая технология
станет доминирующей, пока неизвестно.
